KRI 霍爾離子源典型應(yīng)用 IBE 離子刻蝕閱讀數(shù): 11611

離子源應(yīng)用于離子刻蝕 IBE
上海伯東代理美國(guó)考夫曼 KRI 離子源, 其產(chǎn)品霍爾離子源 EH400 HC 成功應(yīng)用于離子蝕刻 IBE.
霍爾離子源離子抨擊能量強(qiáng), 蝕刻效率快, 可因應(yīng)多種基材特性, 霍爾源單次使用更久, 耗材成本極低, 操作簡(jiǎn)易, 安裝簡(jiǎn)易, 因此美國(guó)考夫曼霍爾離子源廣泛應(yīng)用于蝕刻制程及基板前處理制程.
霍爾離子源客戶案例一: 某大學(xué)天文學(xué)系小尺寸刻蝕設(shè)備
系統(tǒng)功能: 對(duì)于 Fe, Se, Te ,PCCO 及多項(xiàng)材料刻蝕工藝.
樣品尺寸: 2英寸硅芯片.
刻蝕設(shè)備: 小型刻蝕設(shè)備. 選用上海伯東美國(guó)考夫曼品牌霍爾離子源 EH400 HC
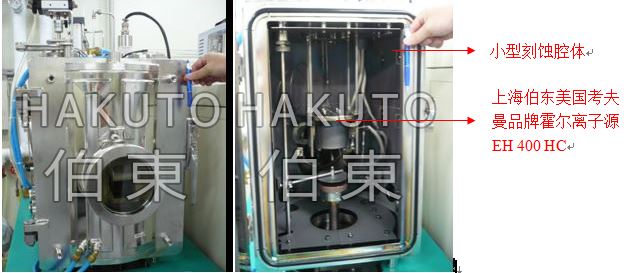
霍爾離子源 EH400HC 安裝于刻蝕腔體內(nèi)

離子源 EH400HC 自動(dòng)控制單元

霍爾離子源 EH400HC 通氬氣

對(duì)于 FeSeTe 刻蝕應(yīng)用, 霍爾離子源 EH400HC 條件: 110V/1.5A, 刻蝕速率 >20 A/Sec

對(duì)于 FeSeTe 刻蝕應(yīng)用, 霍爾離子源 EH400HC 條件: 110V/1.5A, 刻蝕速率 >17 Å/Sec

鑒于信息保密. 更詳細(xì)的離子源應(yīng)用歡迎撥打客服熱線:021-5046-3511
霍爾離子源 EH400HC 特性:
高離子濃度, 低離子能量
離子束涵蓋面積廣
鍍膜均勻性佳
提高鍍膜品質(zhì)
模塊化設(shè)計(jì), 保養(yǎng)快速方便
增加光學(xué)膜后折射率 (Optical index)
全自動(dòng)控制設(shè)計(jì), 操作簡(jiǎn)易
低耗材成本, 安裝簡(jiǎn)易
1978 年 Dr. Kaufman 博士在美國(guó)創(chuàng)立 Kaufman & Robinson, Inc 公司, 研發(fā)生產(chǎn)考夫曼離子源, 霍爾離子源和射頻離子源. 美國(guó)考夫曼離子源歷經(jīng) 40 年改良及發(fā)展已取得多項(xiàng)成果. 離子源廣泛用于離子清洗 PC, 離子蝕刻 IBE, 輔助鍍膜 IBAD, 離子濺射鍍膜 IBSD 領(lǐng)域, 上海伯東是美國(guó)考夫曼離子源中國(guó)總代理.
若您需要進(jìn)一步的了解 KRi 離子源, 請(qǐng)參考以下聯(lián)絡(luò)方式
上海伯東: 葉小姐 臺(tái)灣伯東: 王小姐
T: +86-21-5046-3511 ext 107 T: +886-3-567-9508 ext 161
F: +86-21-5046-1490 F: +886-3-567-0049
M: +86 1391-883-7267 M: +886-939-653-958
上海伯東版權(quán)所有, 翻拷必究!

 上海
上海